Elektronik devrelerde sıklıkla kullanılan Ball Grid Array (BGA) teknolojisi hakkında bilmeniz gerekenleri bu yazımızda bulabilirsiniz.
Ball Grid Array ya da BGA paketleri, bir çeşit yüzey montaj teknolojisidir. Yüzey montaj teknolojileri, entegre devrelerde yaygın olarak kullanılmaktadır. BGA, sunmuş olduğu çok sayıda avantajla birlikte elektronik devre üretiminin vazgeçilmez parçası haline gelen, çiplerin herhangi bir soket kullanılmadan, doğrudan PCB’ye lehimlendiği yapıya verilen isimdir.
Çok sayıda pine sahip entegre devreler için daha etkili ve mantıklı bir paket sistemine ihtiyaç duyulduğu için BGA paketleri geliştirildi. Entegre devrelere olan ihtiyacın artması ile birlikte bazı devreler 100’den fazla pine sahip hale gelmişti.
Konvansiyonel tasarıma sahip paketler, çok ince ve sıkı yerleşime sahip pinlere sahiptir. Bu da kontrollü ortamlarda bile çok kolay hasar oluşmasına neden oluyor. Bu paketlerin lehimlenme işleminin de çok dikkatli yapılması gerekiyor. Yoksa lehim fazlalıkları kötü yerleşime sebep oluyor.
Tasarım açısından bakıldığında, pin yoğunluğu bu kadar fazla olduğu için devreden çıkan yollarda da sıkışıklık meydana geliyor. BGA paketleri bu sorunları aşmak için geliştirildi ve lehimlenmiş parçaların güvenilirliğini de artırdı.
BGA’nın Amaçları
BGA, entegre devre ve elektronik parça üreticilerine, dolayısıyla da bu ekipmanları kullananlara birçok avantaj sağlamak üzere geliştirildi. Bu teknolojinin avantajlarını maddeler halinde özetleyebiliriz:
- Kartlardaki devre alanının etkili kullanımı, paketlerle bağlantının sadece dış kısımdan değil, alttan da yapılmasına olanak sağlaması.
- Termal ve elektrik performansı açısından geliştirmeleri içermesi (BGA paketleri, düşük iletkenliğe ya da kontrollü empedansa sahip yollar için yeterli güç sağlıyor ve kanallar yardımıyla fazla ısıyı dışarıya yönlendiriyor).
- Lehimleme işlemini daha etkili hale getirdiği için üretim sürecini olumlu etkilemesi, bağlantılar arasında daha geniş boşluğa izin verip lehimleme işlemini kolaylaştırması.
- Paket kalınlığını azaltması nedeniyle cep telefonları gibi daha ince üretilmesi gereken cihazlarda kullanım avantajı sağlaması.
- Devrelerin üzerinde yeniden çalışılması için uyumluluğun artırılması.
BGA Paketi Nedir?
BGA, konvansiyonel yüzey montaj bağlantılarından daha farklı bir yaklaşım izliyor. Diğer paketler, örneğin Quad Flat Pack (QFP) bağlantılar için çevreyi kullanıyor. Pinler de çok yakın yerleştiği için bağlantı sağlayacak oldukça küçük bir alan kalıyordu. BGA ise paketin altını da kullanıyor ve bağlantılar için yeterli bir alan sağlıyor.
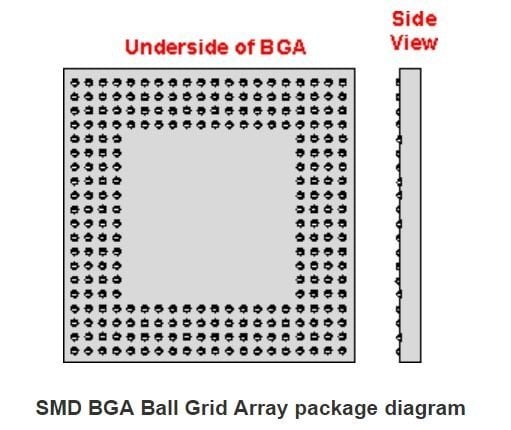
Pinler ızgara dokusunda çip taşıyıcısının alt yüzüne yerleştiriliyor. Ayrıca bağlantı sağlayacak pinler yerine lehim toplarıyla kaplı padler kullanılıyor. Eşleşen bakır padlerle birlikte de devre kartı üzerinde gerekli bağlantı sağlanmış oluyor.
Bağlantılardaki geliştirmelerin yanında, BGA diğer avantajlara da sahip. QFP ile kıyaslandığında silikon çipin kendisinde daha düşük termal direnç sunuyor. Böylelikle entegre devrede oluşan ısı, kart üzerine daha hızlı ve etkili şekilde aktarılıyor. Bu sayede özel soğutma önlemlerine gerek kalmadan BGA cihazlarının daha fazla ısı üretebilmesine olanak sağlanmış oluyor.

Çip taşıyıcısının alt yüzeyinde yer alan iletkenler ile birlikte çip üzerindeki yollar daha kısa hale geliyor. Böylelikle lehimin istenmeyen iletkenlik düzeyi azalıyor ve QFP ile kıyaslandığında daha yüksek performans sunuluyor.
BGA Paket Türleri Nelerdir?
Farklı tipteki ekipmanlar ve üretim seçenekleri için BGA’nın birçok farklı türü geliştirildi.
- MAPBGA – Moulded Array Process Ball Grid Array: Bu BGA paketi düşük ve orta performans sınıfındaki cihazlar için geliştirildi. Özellikle kolay yüzey montajı ve az indüktans gerektiren işler için ortaya çıkarıldı. Yine de yüksek kararlılığa sahip olan bu BGA türü, düşük maliyetli bir tercih sunuyor.
- PBGA – Plastic Ball Grid Array: Bu BGA paketi, orta ve yüksek performans sınıfındaki cihazlar için geliştirildi. İçerdiği ek bakır katmanlar sayesinde daha yüksek gücü kaldıracak şekilde tasarlandı.
- TEPBGA – Thermally Enhanced Plastic Ball Grid Array: Bu paket daha yüksek ısı yayım düzeyine sahip. Kalın bakır katmanlar sayesinde ısı devreden çekilip kart üzerine aktarılıyor.
- TBGA – Tape Ball Grid Array: Bu BGA paketi, ısıyı çeken dış bir kaynağı olmayan ancak yüksek termal performans gerektiren orta ve yüksek sınıftaki cihazlar için geliştirildi.
- PoP – Package on Package: Bu BGA paketi, alanın çok önemli olduğu uygulamalarda ön plana çıkıyor. Ana cihaz üzerine bir hafıza paketi konulmasına olanak sağlıyor.
- MicroBGA: İsminin de işaret ettiği gibi bu BGA paketi daha küçük. 0.65, 0.75 ve 0.8 mm gibi boyutlara sahip bu BGA paketleri endüstride kullanılıyor.
BGA Montajı
BGA paketleri tanıtıldığında, montaj konusu şüpheyle bakılan temel noktalardan birisiydi. Ancak paketler kullanılmaya başlandığı zaman, standart yöntemlerin de bu paketler için uygun olduğu ve montaj kalitesinin oldukça iyi olduğu ortaya çıktı. BGA montaj yöntemleri daha da gelişti ve artık BGA lehimlemesi de oldukça güvenilir kabul ediliyor.
Lehimleme işleminde, lehim topları dikkatlice kontrol edilmiş lehim miktarına sahip ve bu işlem sırasında ısıtıldıklarında lehim eriyor. Yüzey gerilimi, erimiş lehimin kart üzerinde düzgün şekilde tutulmasını sağlıyor. Lehimin bileşenleri ve sıcaklığı dikkatlice seçiliyor ve tamamen erimeyeceği ama katı-sıvı formunda kalacağı bir halde tutulması sağlanıyor. Böylelikle her lehim topu komşularından ayrı kalıyor.

BGA paketlerini kullanan cihazların da artmasıyla birlikte, BGA montaj yöntemleri de daha iyi anlaşıldı ve birçok üretici tarafından kolaylıkla gerçekleştiriliyor. BGA cihazlarını bir tasarımda kullanmakta endişe duyulacak bir nokta yok.
BGA Cihazlarının Test Edilmesi
BGA cihazlarının bir problemi ise optik yöntemler ile lehimlenmiş bağlantıları göstermenin mümkün olmaması. Bu teknoloji tanıtıldığında, üreticiler bu yüzden şüphe ile yaklaştılar ve lehimleme işleminin etkin yapılıp yapılmadığını test ettiler. BGA cihazlarıyla ilgili temel problem, ızgaradaki lehim toplarını etkili şekilde eritecek yeterli ısının uygulandığından emin olunması gerekliliğiydi.
Elektrik performansını test ederek montaj eklemlerinin tam testini yapmak da mümkün olmuyor. Eklemlerin düzgün şekilde yapılmayıp, zamanla çalışamaması mümkün olabiliyor. Şu an için tatmin edici tek inceleme yöntemi X-ray. Lehim makinesinin ısı profilinin düzgün şekilde ayarlandığından emin olunduğu zaman, BGA cihazları çok iyi lehimleniyor ve çok az sorunla karşılaşılıyor. BGA montajı da çoğu uygulama için mümkün oluyor.
BGA Onarımı/Reballing
BGA paketi sökülüp yerine yenisi takılabilir. Genellikle söküldüğü zaman BGA paketlerini onarmak ya da yenilemek mümkün oluyor. BGA onarımı eğer çip pahalı ise mantıklı hale gelebiliyor.
Onarım işlemi sırasında da lehim toplanın değiştirildiği reballing adı verilen bir işlemin uygulanması gerekiyor. Bu amaçla üretilen ve satılan küçük hazır lehim toplarını kullanmak mümkün. Üreticilerin elinde bu işlem için özelleştirilmiş ekipmanlar da mevcut.








emeğine sağlık. Merakım giderilmiş oldu. Minnettarım..