Intel, gelişmiş paketleme teknolojileri alanında önemli bir ilke imza attı. Şirket Japonya’da düzenlenen NEPCON Japan etkinliğinde sektörün ilk cam çekirdekli (glass core) substrat yapısını kendi EMIB ileri paketleme teknolojisiyle birlikte sergiledi. Bu yeni yaklaşım, özellikle veri merkezleri ve yapay zekâ hızlandırıcıları için geliştirilen gelecek nesil yüksek performanslı yongaların önünü açmayı amaçlıyor.
Intel’den yarı iletkenlerde bir ilk: Cam çekirdekli alt tabaka
Intel Foundry tarafından tanıtılan çözüm geleneksel organik substratların yerini alabilecek kalın çekirdekli cam bir yapı üzerine kurulu. EMIB (Embedded Multi-die Interconnect Bridge) teknolojisiyle entegre edilen bu cam çekirdek tek bir paket içinde çoklu çiplet tasarımlarına imkan tanıyor. Intel’in paylaştığı teknik bilgilere göre paket yapısı 78 mm x 77 mm boyutlarında ve klasik retikül sınırlarının yaklaşık iki katına ulaşan bir alan sunuyor.
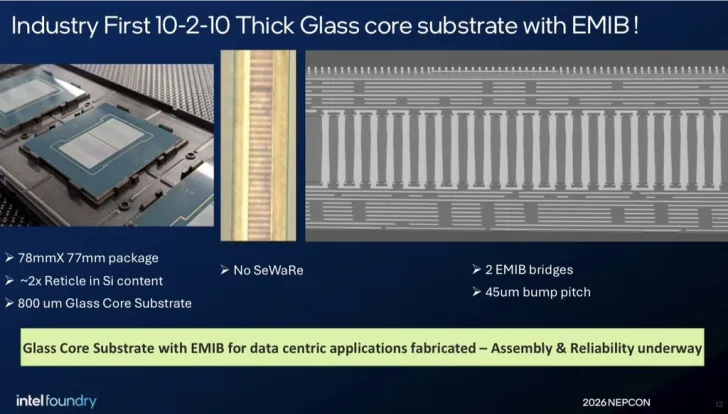
Dikey mimaride 10-2-10 olarak tanımlanan bir katman dizilimi kullanılıyor. Bu yapı, üstte ve altta onar yeniden dağıtım katmanı, ortada ise iki katmanlı cam çekirdek içeriyor.
Camın fiziksel özellikleri sayesinde bu yoğun katmanlı yapıya rağmen daha sık ve hassas bağlantılar mümkün oluyor. Paket içinde halihazırda iki adet EMIB köprüsü yer alıyor ve bu köprüler birden fazla hesaplama yongasının yüksek bant genişliğiyle birbirine bağlanmasını sağlıyor.
Intel’in bu gösterimi cam substrat projelerinin rafa kaldırıldığına yönelik iddiaların da aksine şirketin bu alandaki çalışmalarını sürdürdüğünü ortaya koyuyor. Cam çekirdekli paketleme daha iyi mekanik dayanım, daha düşük gerilim, daha hassas hizalama ve yüksek bağlantı yoğunluğu gibi avantajlar sunuyor. Bu özellikler tek bir süper paket içinde çok sayıda çiplet barındıran yapay zeka hızlandırıcılarının ölçeklenmesini mümkün kılıyor.
EMIB tabanlı bu yeni yaklaşım ileri paketleme tarafında yaşanan tedarik darboğazlarının da etkisiyle yüksek performanslı bilgi işlem şirketlerinin dikkatini çekiyor. Intel Foundry’nin cam çekirdekli EMIB çözümünü üretim seviyesine taşıması halinde gelişmiş paketleme teknolojilerinin şirket için yeni ve stratejik bir gelir alanı haline gelmesi bekleniyor.







